
IGBT的工艺节点,也就是业内常说的工艺pitch,已经缩小到了1.6um,甚至1.2um。但是目前对于关注静态损耗的场合,仍然可以做到2.4um平台达到1.6um平台差不多的效果。或者说,使用同一工艺平台,不同设计所表现出来的静态损耗水平仍然有明显的差别。
这其中很重要的一个原因是载流子限制效应。
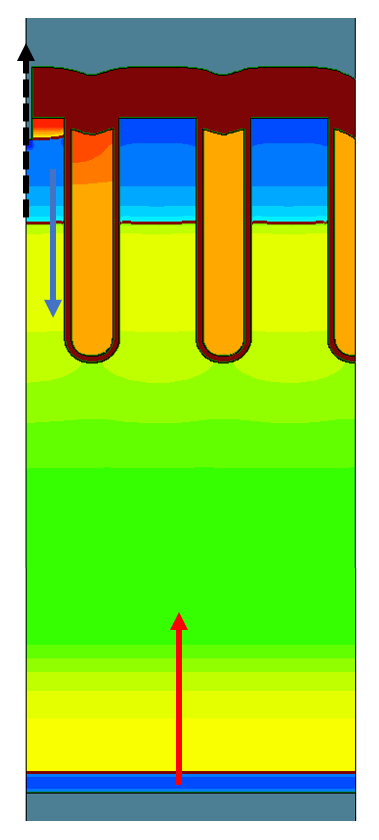
正面沟道注入电子,背面注入空穴。两个动作都是实现中间漂移区载流子浓度的提升。这是IGBT电导调制效应的根本。
但是还有一个降低载流子浓度的效应,就是通过P阱和正面接触会“漏“掉到达正面的空穴。
最终这三个作用所形成的载流子浓度和其分布特点决定了IGBT的损耗水平,以及部分动态表现。
所以,除了提升沟道注入和背面注入之外,限制通过P阱流失的空穴,对提升整体电导率有重要作用。而且与前两条相比,这一措施并不会明显提升短路电流的水平,因而不会明显牺牲短路能力。
载流子限制最直接的做法就是缩小P阱的宽度,也就是沟槽间距,俗称mesa宽度。可能也有观点认为载流子存储层(CS层)也是载流子限制的一种方法,但是本质上讲载流子存储层更多的作用是提升正面的电子注入效应,一方面它明显拓展了沟道电子注入的范围,另一方面实际工艺中的载流子存储层会极大地缩短沟道长度。这个解释在之前的文章里有提到。
很明显,载流子限制与工艺节点具有十分直接的相关性。缩小pitch宽度,往往会缩小mesa宽度。但是这之间毕竟还是隔了一道,比如几个工艺平台,都可以称为2.4um,但是其中一个沟槽间距是1.2um,沟槽宽度也是1.2um,另一个则分别是1.4um和1.0um。如果更多地关注静态损耗,很明显第一种要强一些。
除此之外,设计上差别,也会造成同一工艺平台下不同器件有着不同的损耗表现。
最典型的就是实际接入的P阱宽度,可以有非常多的不同的设计。对于关注动态损耗的场合,多接一些有利于降低开关时建立与消除的载流子数量,从而提升器件应用时的开关频率。这也是从MOSFET设计转向低压IGBT设计时不知不觉就比较顺利的原因。因为电压越低,应用端关注的特性越接近MOSFET,设计方法上也越类似于MOSFET。这也许是思考后的回归常识,也许是偶然间的巧合。
但是设计上仅仅考虑增加和减少这个“漏”的宽度,也很容易出问题。IGBT这样的器件,静态特性和开关特性都会明显受到载流子分布的影响。不只是电导率的影响,还包括电位的影响。仅仅从静态结构分析电容特性去推断IGBT的开关特性经常会差距巨大,甚至南辕北辙。
某一方面带来优势的同时,另一方面可能会带来不可消除的劣势。因而实际的IGBT设计,没有绝对意义上的最优方案,几家国际大厂也通过各自特有、差异明显的设计都得到了应用端的接受和认可。
多了一个电导调制效应后,IGBT的整个机理比MOSFET复杂了许多,而这也是IGBT设计里面有意思的地方。所以,即使多年以后硅材料被SiC替代,IGBT的相关机理对于垂直型功率器件的设计工作也会有所帮助。